摘要
半导体纳米线(NWs)因其在纳米电子器件中作为构建模块的卓越性能而受到广泛关注。具有相对较小的带隙和高电子迁移率的 InAs 纳米线被认为对于高性能电子器件非常有趣。显然,如果这些纳米线要被使用,它们需要具有高稳定性。纳米线的电学特性大多通过自上而下的方法制作金属接触来实现,有时也通过原位透射电子显微镜(TEM)在纳米线的一侧使用扫描隧道显微镜(STM)尖端进行接触。对于高电流引起的击穿起始,已报告了几种机制:由于加热导致的成分变化或分解,以及电迁移。使用 STM 尖端与纳米线一侧接触进行电学测量的一个限制是,与纳米线的电接触质量未知且通常不是欧姆接触。这可能导致 I-V 特性的错误值以及纳米线在该接触点附近的强烈加热。
在本研究中,作者报告了使用自制的原位 TEM 支架和具有良好欧姆接触的纳米线与电极之间的样品,对锥形 InAs 纳米线的电学性质以及击穿进行了原位 TEM 研究。对于直径大于 120 纳米的纳米线,其电阻率是恒定的,约为 10-2 Ω·cm。发现击穿是由电场和焦耳热的联合效应引起的。

(a) 原位电学测量芯片示意图。一根锥形纳米线连接到硅氮(SiN)膜上的四个电极。膜上制作了缝隙,允许无阻碍地对悬挂在这些缝隙上的纳米线进行透射电子显微镜(TEM)成像。(b) 带有铂(Pt)接触点的纳米线的明场TEM图像,接触点显示为黑色区域。(c) 高分辨率TEM图像,显示了大约2纳米的氧化层。(d) 不同直径的电阻率数据(Δ:本文数据,o:文献数据)。(e) 击穿起始的临界电压与直径的关系图。(f) log10(jc)与直径的关系图,其中jc是击穿临界电流密度,单位为A cm⁻²。
「PART 01」研究目标与挑战
✦ 研究目标
-
驱动力:InAs 半导体 NWs 在高性能电子器件中的潜在应用
-
在 InAs NWs 上制造低欧姆触点
-
描述不含实验伪影的 InAs NWs 的电学特性
-
实时观察 NW 击穿的同时发生的电学特性
✦ 挑战
-
使用扫描隧道显微镜进行接触电测量的局限性导致:
-
a.I – V 数值错误
-
b. NW 的强加热
-
击穿起始位置的高分辨率成像
「PART 02」 实验条件
✦ TEM 设备
-
型号:FEI Titan ST
✦ 原位系统
✦ MEMS 设备
-
ST 芯片
-
氮化硅膜与 5nm 的 Cr 层粘合
-
窗口:通孔,尺寸:1.5μm × 5μm
-
电极:金,厚度:95nm,宽度:1μm
-
间距:4μm
✦ 样品
-
InAs 纳米线
✦ 样品制备方法
-
非原位纳米机械手将纳米线转移到原位芯片上
-
Pt 沉积在纳米线和电极的连接处
✦ 原位环境参数
-
电压:达到-1V
-
变化速率:1mV/s
-
温度:500℃
✦ TEM 成像参数
-
加速电压:300 KV
✦ 分析技术
-
HAADF-STEM,EDX,HRTEM
「PART 03」结果
在当前的例子中,通过原位加电 TEM,观察到 InAs NWs 的击穿过程,同时记录了 I-V 曲线图(图1)。从图2 (d) - (k)可以清楚地观察到,NW 的中间部分没有发生击穿,这可以直接地推测出,由于两侧的两个相同的电极和焦耳加热,NW 应该是中心最热的。相反,击穿发生在离阴极更近的地方。在击穿之前,球状颗粒出现在阳极侧附近,其大小和数量都在增长(图2 (j) - (k))。通过 EDX 显示,这些颗粒为铟聚集位置(图3 (b)),而破碎区域为砷聚集位置(图3 (c))。因此,可以推测出击穿机理是基于 In 的电迁移而导致阴极侧 NW 断裂。
研究表明,利用基于 MEMS 的纳米芯片进行电学实验,可以避免由于焦耳加热而引起的 NWs 高温加热现象。同时 TEM 成像和电学测试表明,随着电流的增加,NW 在阴极侧发生击穿。同时提出了电迁移机制和击穿过程的焦耳加热。
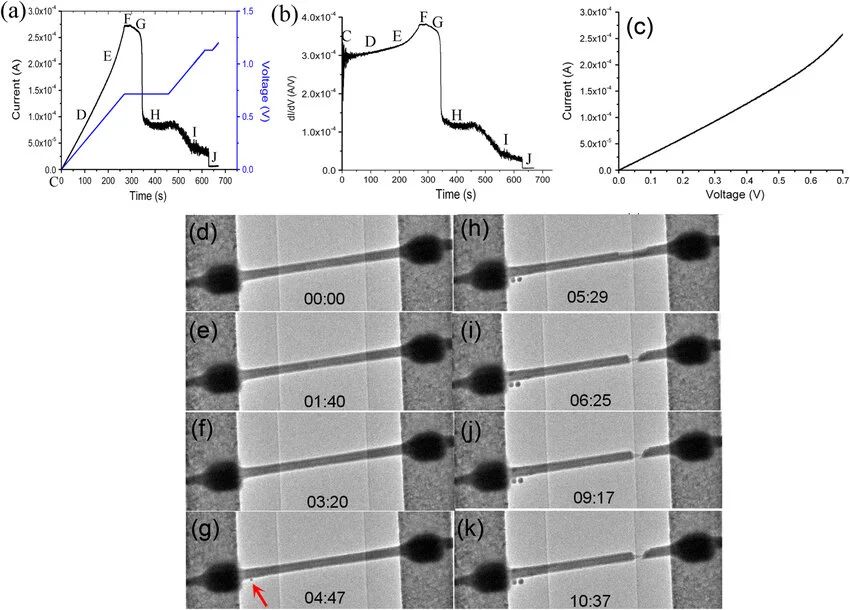
(a) - (c)整个过程中 InAs NW 的 I-V 随时间变化曲线。(d) - (k)在(a)和(b)中所示的一些点对应的TEM图像
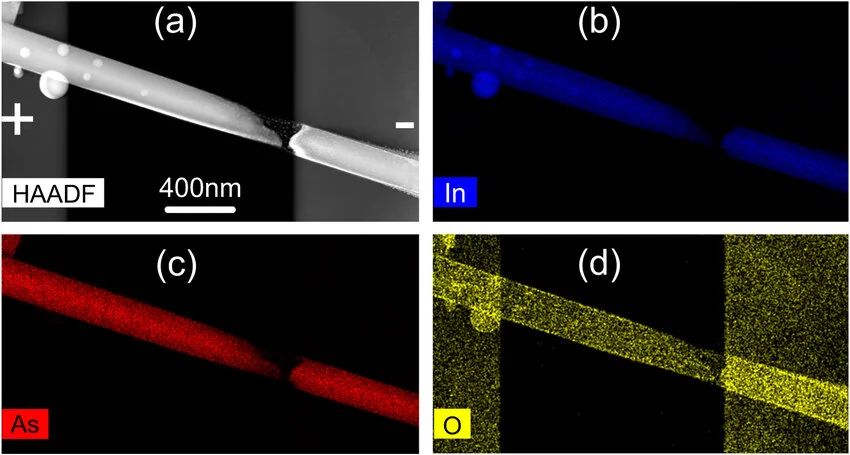
(a)击穿后 InAs NW 的 HAADF 图像,在靠近阳极处观察到铟颗粒,而击穿发生在靠近阴极处。(b) - (d) InAs NW的 EDX 元素分布图。
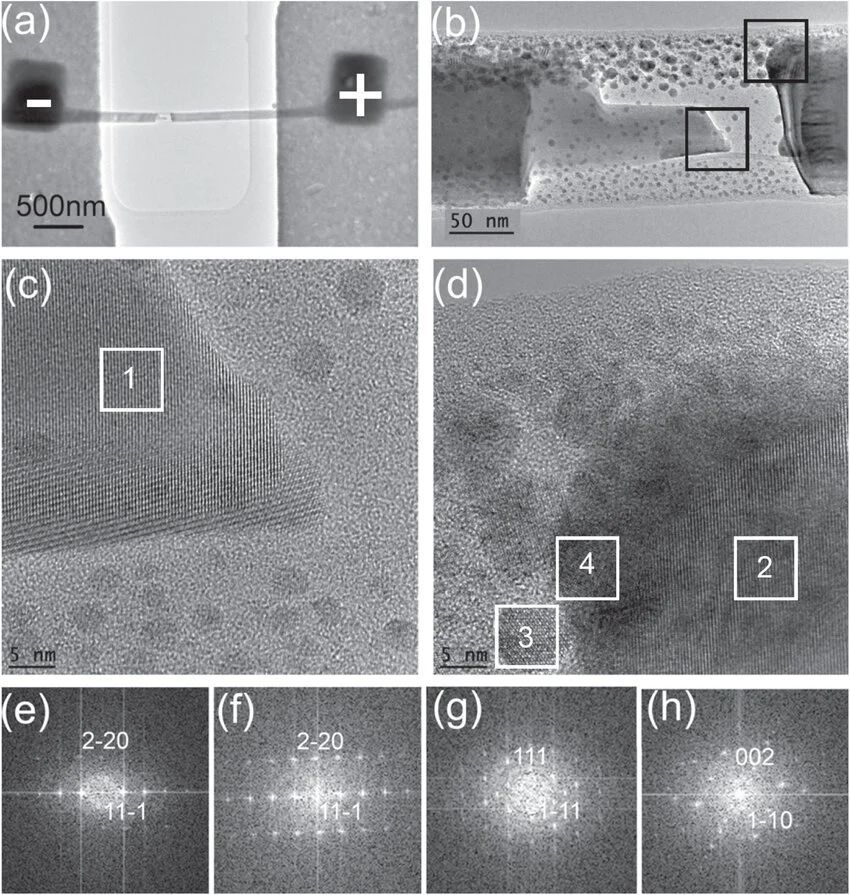
(a) 击穿后锥形 InAs 纳米线的低倍放大图像。(b) 断裂区域的放大图像。(c) 和 (d) 分别对应于 (b) 中左侧和右侧方框区域的高分辨率电子显微镜(HRTEM)图像。(e) 至 (h) 分别对应于 (c) 和 (d) 中标示的区域1至4的快速傅里叶变换(FFT)图案。
「PART 04」结论
本研究展示了原位偏压 TEM 技术在监测半导体纳米线电学性质动态变化方面的应用潜力。通过实时观察和 I-V 测量,可以更深入地理解纳米线的击穿机制,为高性能电子设备的设计和制造提供重要信息。
DENSsolutions Lightning TEM 原位热电样品杆

了解更多 DENSsolutions 原位样品杆产品详情与应用案例,欢迎联系我们。咨询热线:400 857 8882
参考文献
Zhang, Chao, et al. “In situ electrical characterization of tapered InAs nanowires in a transmission electron microscope with ohmic contacts.” Nanotechnology 26.15, 15570 (2015)
往期推荐

如果您想要了解更多产品信息,请填写以下信息下载产品手册, 我们收到您的信息后将第一时间回复您。











